早在十年前,英特爾就開始尋找有機基板的真正替代品,一種能夠與大型芯片完美配合的基板,在亞利桑那州的CH8工廠試生產玻璃基板。作為封裝基板領域的探索引領者,2023年9月,英特爾推出基于下一代先進封裝的玻璃基板展示了一款功能齊全的測試芯片,計劃于2030年開始批量生產,該芯片使用75微米的玻璃通孔,縱橫比為20:1,核心厚度為1毫米。
英特爾的新技術不僅僅停留在玻璃基板的層面,還引入了Foveros Direct(一種具有直接銅對銅鍵合功能的高級封裝技術),為可共同封裝光學元件技術(CPO)通過玻璃基板設計利用光學傳輸的方式增加信號,并聯合康寧通過CPO工藝集成電光玻璃基板探索400G及以上的集成光學解決方案。
英特爾與設備材料合作伙伴展開了密切合作,與玻璃加工廠LPKF和德國玻基公司Schott共同致力于玻璃基板的產品化。另外,英特爾還帶頭組建了一個生態系統,已經擁有大多數主要的EDA和IP供應商、云服務提供商和IC設計服務提供商。“現在是齊心協力實現封裝領域下一次轉型的時候了。”英特爾表示。
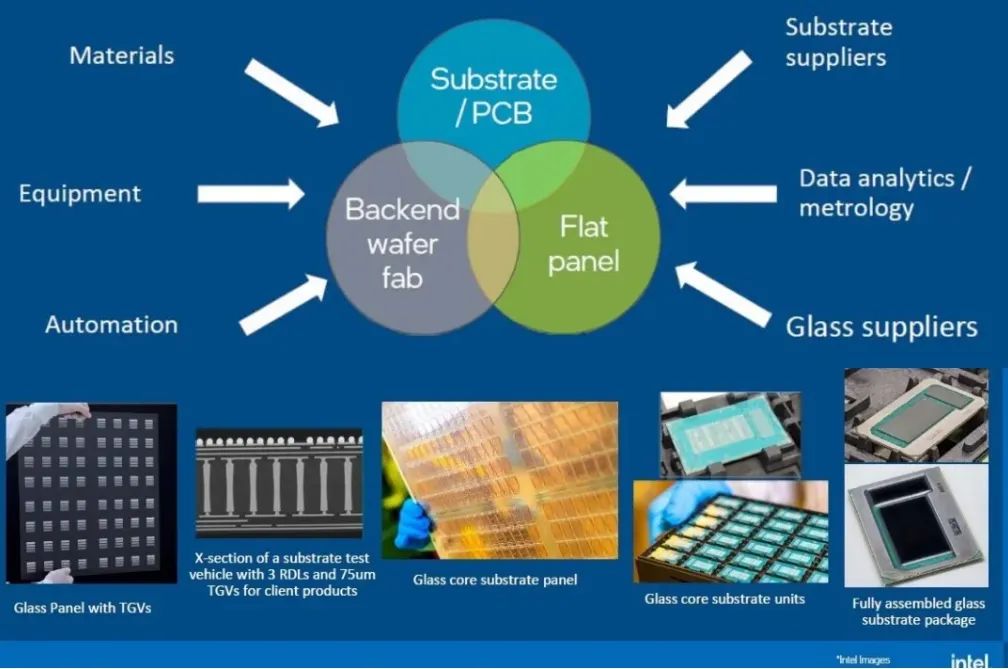
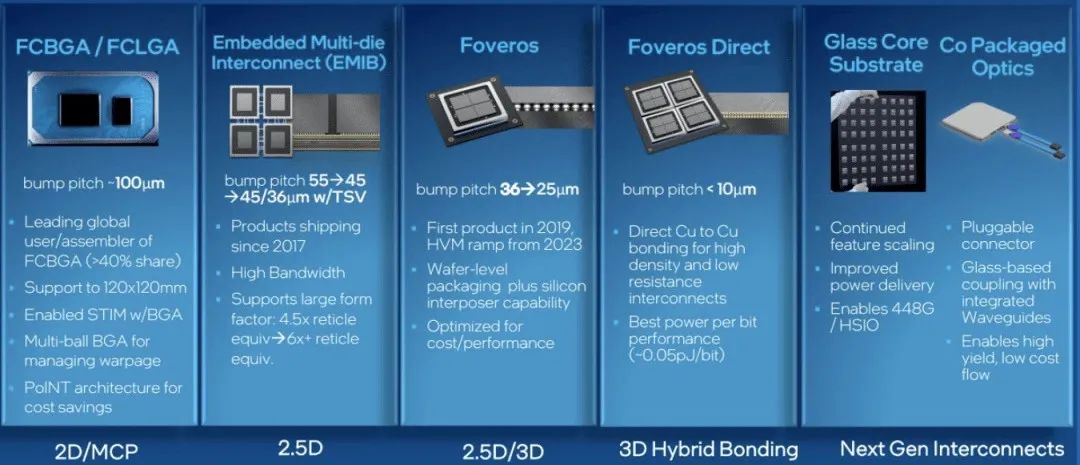
玻璃基板可為英特爾帶來巨大的競爭飛躍,可以看到它已被添加到最新的路線圖產品中。英特爾正朝著2030年在單個封裝上集成1萬億個晶體管的目標前進,玻璃基板將是推動這一目標落地的強有力支持。
三星自然無法直視英特爾玻璃基板業務上鶴立雞群,終于在今年宣告了加速玻璃基板芯片封裝研發。2024年3月,三星集團子公司三星電機宣布與三星電子和三星顯示器組建聯合研發團隊(R&D),三星電子預計將專注于半導體和基板的集成,而三星顯示器將處理與玻璃加工相關的方面,以在盡可能短的時間內開發玻璃基板并將其商業化。
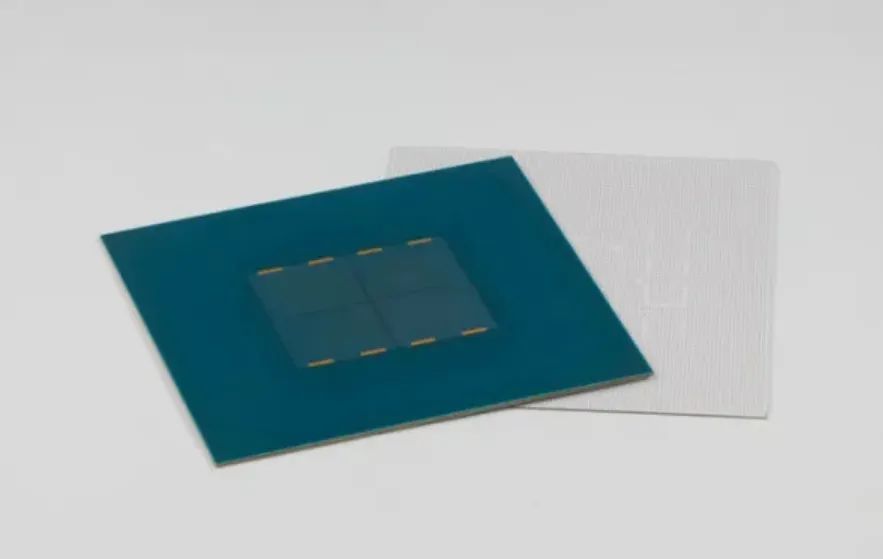
三星電機的玻璃基板
成立“新軍團”加碼研發,這足以見得三星對玻璃基板的重視。事實上,三星電機已在CES上就宣布計劃于2025年生產樣品、2026年大規模生產玻璃基板,比英特爾更快地實現商業化。而在這項技術領域中,除了英特爾和三星,已有多個強勁對手入局。
· 3月25日,LG Innotek也宣布入局玻璃基板的開發,將半導體基板做到第一是他們的業務目標。在回答有關發展半導體玻璃基板業務的問題時,其CEO表示:“我們半導體基板的主要客戶是美國一家大型半導體公司,該公司對玻璃基板表現出極大的興趣。當然,我們正在為此做準備。”
· 日本DNP公司展示新開發成果玻璃基板,示意圖甚至完全從封裝中省略了細間距載板,暗示這部分可能不再需要。據介紹,使用玻璃基板可以實現更精細的間距,因此可以實現極其密集的布線,因為它更硬并且不易因高溫而膨脹。DNP表示相信玻璃將在倒裝芯片球柵陣列等高端芯片封裝中取代樹脂,提出了在2027年大規模量產TGV玻璃基板的目標。
· 作為全球第一大基板供應商,日本Ibiden也在去年10月宣布,擬將玻璃基板作為一項新業務研發。據知情人士透露,當前Ibiden正處于半導體封裝用玻璃芯基板技術的探索階段。
· SK集團旗下的Absolics,去年又投資了6億美元,計劃在喬治亞州科文頓建一座月產能達4000塊的玻璃基板工廠。Absolics表示隨著微處理的性能提升已達到極限,半導體行業正在積極利用異構封裝,但現有的半導體載板必須通過稱為硅中介層的中間載板連接到半導體芯片,而內置無源元件的玻璃載板可以在相同尺寸下集成更多的芯片,功耗也減少了一半。
當前,在先進工藝領域臺積電依舊領先,臺積電CoWoS擁有較高的專利壁壘。英特爾和三星的積極部署,可以理解為是其迎戰臺積電的一大策略,除在工藝層面加緊布局之外,先進封裝領域也需要尋求新的路徑實現追趕甚至超越,而玻璃基板成為一個最佳的“跳板”,雖然不能在最高級別取代CoWoS/EMIB的需求,但可以提供比當前有機基板更好的信號性能和更密集的布線。
有行業專家表示,臺積電對玻璃基板雖然還沒有相關動作,但應該也在密切關注。臺積電在CoWoS領域火力全開,接連獲得大廠訂單享受紅利,因而并不急于投入巨資押注玻璃基板,仍將繼續沿著現有路徑升級迭代,以保持領先地位不可撼動。而一旦臺積電覺得時機成熟,將會大幅加碼。





























